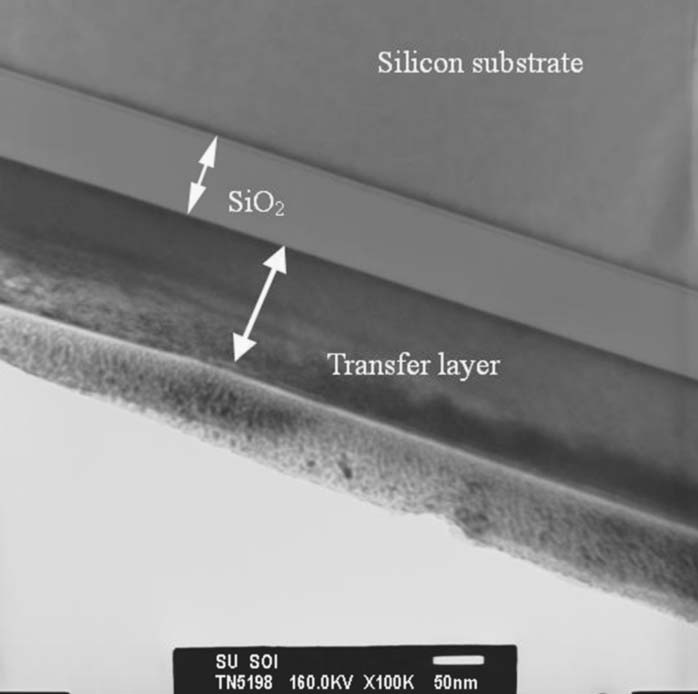
氫分離單晶矽基薄膜科學及技術研究
Hydrogen Lift-off Single Crystal Silicon Layer Scientific and Technology
【技術發展背景】
合成奈米厚度薄膜材料是當今半導體及光電工業界進入相關奈米製程所需求的材料技術,特別是用來製作含有一單晶、大面積、低缺陷密度晶的奈米厚度薄膜厚度的基板。由於合成一與基板材料相異之單晶薄膜材料非常難製作,使得此類技術成為發展奈米製程的指標技術。此種薄膜合成的方法,主要有兩大類:直接磊晶在工作基板上生長想要的材料薄膜;或是在一想要的材料基板上,切下一片薄膜,再黏貼在工作基板上。後者稱為單晶薄膜轉移技術。
現今單晶薄膜轉移技術為歐、美、日科技先進國家急亟發展的項目,因為不僅僅只有材料的轉移,還可擴充至 IC
元件的轉移。這項技術包括兩大關鍵:一、晶圓鍵合 (Wafer Bonding) 及 二、薄膜轉移 (Layer Transfer)。
圓鍵合技術能將兩晶格常數相差甚遠的單晶晶圓片互相結合,而不需使用任何黏膠,使中間的鍵合介面仍能保持超級潔淨,滿足微電子及光電材料對介面屬性嚴苛的要求。該技術起初由中國南京的東南大學微電子所童勤義教授研究小組,及美國 Duke 大學的 U. Gösele 教授的 Wafer Bonding Laboratory 八十年代進行研究發展,在傳感器 (Sensor) 元件製作上取得重大突破。至 1992 法國的 SOITec 將之與氫離子佈植方法結合,成為 Smart-Cut (智切法) 製程,使晶圓鍵合製程揚名於世。在美國方面, UC - Berkeley、UC - Davids、MIT、Cornel、Northwest、Case Western Reserve Univ. 等研究機構隨後加入應用於MEMS領域,遂使 Wafer Bonding (晶圓鍵合) 製程成為顯學。
晶圓鍵合技術依執行方法,可略分為:(1) 陽極鍵合法 (Anodic Bonding)、(2) 直接鍵合法 (Direct Bonding)、(3) 真空鍵合法 (Vacuum Bonding)、(4) 黏接鍵合法 (Adhesive Bonding)、(5) 離子加強鍵合法 (Ion Enhanced Bonding) 、(6) 電漿活化鍵合法 (Plasma Activation Bonding) 、(7) 共晶低溫鍵合法 (Eutectic Low Temperature Bonding)。
在眾多由單晶基板分離出單晶薄膜方法中,以分離出單晶矽薄膜為研究的焦點,因為矽基板材料之研究最為透徹且成熟,應用廣泛,材料取得不難,成本也低。
1988年, IBM 應用磊晶方法製作一種蝕刻停止層 (Etch Stop Layer), 然後再以鍵合 ─ 背蝕(bonding - etching back)方式,製造次微米厚度的絕緣層矽晶圓 (SOI)。然而該技術有腐蝕停止層在各點之停止腐蝕機構工作時間不一,影響膜厚均勻度 (Total Thickness Variation, TTV)的缺點,此外,該制程十分費時,不但浪費原始基板,而且其所産生之廢棄溶液也易造成環境污染問題,使得製作成本居高不下。
同一時期,IBM也發展應用氧離子直接植入法 (Separation by Implantation Oxygen, SIMOX)來發展製作SOI材料。該製成需要植入非常高劑量的氧離子 (約 5X1018/cm2 ) ,雖然經過高溫退火處理,仍然無法使因植入離子造成之缺陷全部消除。
一九九二年,法國人布魯爾博士 (Dr. M. Bruel) 發明「智切法」 (Smart Cut ® Process) 。智切法能使鍵合式SOI材料薄膜厚度亦具有如SIMOX優異的均勻度。依據布魯爾於美國專利文件 (U.S. Patent 5,374,564) 所請求之專利範圍 (Claims) 描述,該制程步驟是先於一原始基板中植入高劑量(約 1 X1017/cm2 )如氫、鈍氣等氣體的離子,然後與另一目標基板鍵合成一體,接著再施以加熱處理 (heating),使該等離子在植入層中聚合,産生許多微氣泡 (microbubbles)。隨後這些微氣泡連成一片,進而分離上下材質,産出薄膜。由於智切法所得之薄膜均勻度十分良好,缺陷密度小,且無腐蝕液産生,氫氣逸出後也無毒無害,沒有環境污染問題,且可以回收原始基板材料。
以上氧離子直接植入法 (SIMOX) 或是智切法 (Smart-Cut Process) 皆以離子植入的能量來控制 SOI 膜厚。眾所周知,在半導體進入奈米等級要求下,氧離子直接植入法所產生的缺陷,特別是在超薄的 SOI 層中因植入氧離子所產生之氧析出物,危害最終元件的良率甚鉅,不易達到基板品質標準的要求。智切法以氫離子分割材料製作SOI,雖然沒有氧析出物的危害,但是在控制超薄奈米等級 SOI 膜厚上卻遇到困難。原因是氫離子質量太小,儘管降低植入能量,植入深度仍不易縮短至奈米等級;在薄膜轉移之後還須以化學拋光方式或腐蝕方式減薄SOI 膜厚至超薄厚度。如此一來,便使離子植入法控制精準厚度的優勢意義減少,因在減薄過程中,厚度準確度將大幅降低,特別是在奈米等級的嚴格要求下。
因應智切法無法達到完美奈米級厚度的缺點,IBM在1999年發明一種方法 (US Patent #5,882,987) 來製作超薄SOI晶圓:第一步,先長一層腐蝕停止層(Etch Stop Layer)在一片矽基板上;然後第二步,再長一層超薄單晶矽層在此腐蝕停止層上;第三步,運用智切法將此兩層矽層連同一些多餘的矽一同自該矽基板切下,轉移至一目標基板。然後將此目標基板作表面腐蝕,將腐蝕停止層之前的多餘矽腐蝕除去,如前述腐蝕停止層方法,製作超薄SOI晶圓片;此法大幅改善前述方法之腐蝕最終效果及縮短時間,但亦顯現TTV不均勻缺點。由此觀之,以氫離子植入達到準確的奈米深度相當困難,運用磊晶犧牲層方法是該難題解答之一。
【在NanoClub 的研究發展】
【1】Smart-Cut Based Layer Transfer Technology: Directly scaled down the thickness of transferred layer below 100 nm. 避開研磨、拋光製程,準確控制單晶矽轉移薄膜,奈米厚度一 次到位!
研究內容: 以犧牲層定位方式,轉移奈米等級 (<100 nm) 單晶矽薄膜於另一基板上。
Description: Transfer a single crystal silicon layer onto a handle substrate at nanoscale thickness defined by sacrificial layer.
學術研究進度:該研究結果已在高知名度期刊發表 ( Applied Physics Letters 90 203119 (2007))。
NanoClub
研究小組運用磊晶方法控制在氧化層上之磊晶犧牲層厚度,再執行氫離子植入步驟,穿過磊晶犧牲層及矽晶工作層,碎化矽晶工作層以下之固體層,經鍵合至另一晶圓片上,最終剝離轉移整體磊晶犧牲層及矽晶工作層薄膜層,使最終矽晶工作層厚度達到奈米標準,一方面能夠避免腐蝕停止層製作,亦避免化學拋光減薄步驟,對奈米等級超薄SOI晶圓片最終品質及成本,均有大幅改善。
實驗步驟:
(1)先在矽基板上,以濕式氧化層生長方式生長一高溫氧化層薄膜 (thermal oxide layer)。
(2) 進行一矽磊晶成長製程 (Epitaxial Growth) 生長一矽薄膜在此一矽基板上的高溫氧化層薄膜表面上,並使得此該薄膜內的摻雜原子(doping)在濃度 (concentration) 或種類 (species) 上與該原始基板相同;
(3) 執行一離子植入製程 (Ion Implantation),將離子或分子植入該原始基板寫且植入深度大於在該複合薄膜層厚度,在該複合薄膜層與該植入離子濃度高峰處 (peak) 之間,形成一充滿植入離子之闢裂層;
(4) 接著利用 NanoClub 發展之低溫電漿活化晶圓鍵合法,將該包含複合薄膜層矽基板與一目標基板鍵結成一鍵合構造體;然後
(5) 升高該鍵合構造體溫度,該鍵合構造體內之闢裂層的離子作一激活處理。此離子激活處理,經由應用高頻交替電場或磁場,例如微波(Microwave)、高周波 (Radio Frequency) 或電感應耦合 (Inductive Coupled)等照射,進行離子激活處理,使該等植入離子激活後,藉由在該植入離子濃度高峰處 (peak) 與該薄膜之間的摻雜物 (dopant) 進行催化反應 (catalysis),形成氣體核種。
(6) 聚合氫氣體分子於佈植缺陷濃度高峰處,填充于該氣體分子所造成之核種中,膨脹碎裂周圍固體結構,進而
(7) 將該薄膜層自該原始基板分離並轉移至該目標基板上。
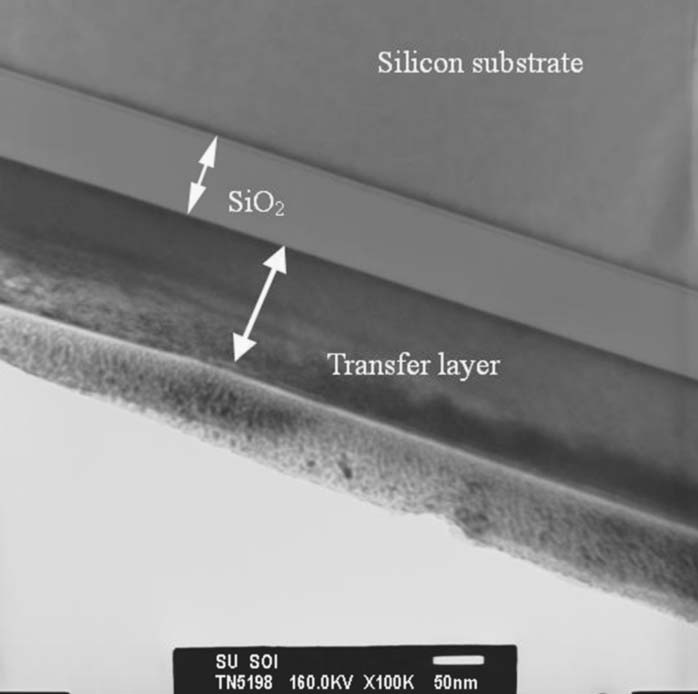
圖為 100nm 厚的矽晶薄膜直接轉移到一矽晶圓上
【2】氫擴散單晶矽薄膜轉移研究 I:次微米 單晶薄膜製作 (世界第一完全不用研磨、拋光製程!)
(Study on Single Crystal Silicon Layer Transfer by Hydrogen Diffusion I )
研究內容: 以離子擴散方式,取代高劑量氫離子佈植來注入氫離子,轉移奈米等級 (<100 nm) 單晶矽薄膜於另一基板上。
Description: Transfer a single crystal silicon layer onto a handle substrate at nanoscale thickness by hydrogen diffusion without a high dose ion implant step.
本研究是藉由擴散入矽基板的氫離子,在矽晶圓基地與磊晶薄膜之間的摻雜物 (dopant)層 進行催化反應 (catalysis),形成核種,聚合氣體分子,填充于該氣體分子所造成之核種中,破碎核種周圍固體,將磊晶層與基板分離轉移至目標基板上,形成由磊晶層生長控制厚度的 SOI 結構。因一定的摻雜原子濃度具有相對應之超過臨界濃度的氫離子,才能有效地產生氣泡。由於磊晶層可以磊晶製程準確地控制厚度,使轉移之複合薄膜層上之工作薄膜層能夠精準至奈米等級,不需經過CMP等機械化學拋光製程,使得薄膜厚度控制能夠達到奈米級的要求。在本研究中,一定量之摻雜原子濃度具有與相對應植入離子濃度,始能使複合薄膜層以下之固體能恰好碎裂至磊晶層之邊界。因此以 (1)磊晶製程控制薄膜層厚度;(2) 磊晶製程控制薄膜層內摻雜原子濃度; (3)氫離子擴散製程控制所植入離子之濃度-以上皆為半導體工業非常成熟的製程技術,便能準確控制薄膜厚度且控制產生之氣泡範圍侷限於複合薄膜邊界與氫離子濃度高峰處。
本研究成功應用磊晶層厚度與植入原子濃度對植入離子的分離反應的影響,來控制薄膜厚度,相異於前述Smart-Cut以經過CMP等機械化學拋光製程來減薄薄膜厚度的方法。
學術研究進度:2008年委託美國勞倫斯實驗室合成預置埋層結構,並與洛杉磯加州大學化材系的 Hicks 教授以常壓式電漿製程,完成氫離子擴散步驟,成功製作世界第一純粹以氫擴散方式完成無缺陷無應力之薄膜轉移。該研究結果已於薄膜類頂尖期刊發表 (Electrochem. Solid-State Letts. 12 H423 (2009) 。
技術推展:2010-2012年擬與中國砂輪公司 (台灣,新竹) 建立試產線。
[附註] 中國砂輪公司之再生晶圓拋光技術獨步全球,並於 2009 Semicon Taiwan 發表 450 mm (18") 矽晶圓 CMP拋光技術。
未來展望:完全不需研磨拋光,直接轉移製作 (1) 厚膜 SOI材料 (1 ~70 um) (2) 全空乏區薄膜 SOI材料,100 nm 以下厚度 (預定目標: 22 nm) 之大尺寸 (12" or larger) SOI 晶圓材料,以應付 65 nm IC 節點時代來臨之材料需求。
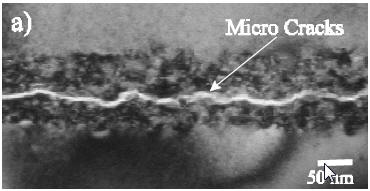
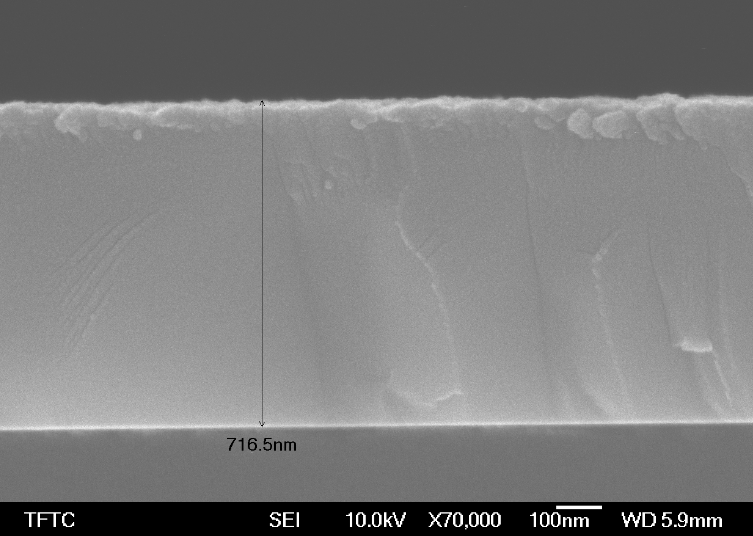
[ 左圖為一般 Smart-Cut 佈植氫離子,經加熱後產生微裂縫來分離薄膜 *;右圖為由 NanoClub 發展出來之氫擴散分離薄膜方式產生的矽薄膜,無損傷層產生,且分離面十分筆直均勻 ]
*Höchbauer T. et al., Investigation of the cut location in hydrogen implantation induced silicon surface layer exfoliation, J. of Appl. Phys., Vol. 89, No. 11 (2001)

【原理圖說】Inside of silicon, hydrogen can form H2 molecules, cover extended internal surfaces (called platelets) and stick to various other defects (including vacant sites, extra Si atoms and all manner of impurities). (111) hydrogen containing platelet in silicon. The space between the planes is filled with a high pressure phase of molecular hydrogen.
Adopted form http://phys.strath.ac.uk/information/acadstaff/benjamin.hourahine.php
【3】氫擴散單晶矽薄膜轉移研究 II:超薄矽晶薄膜製作.gif)
(Study on Single Crystal Silicon Layer Transfer by Hydrogen Diffusion II)
研究內容: 在第一代研究基礎上,發展以超低劑量氫離子植入擴散加強方式,轉移一奈米等級 (< 50 nm) 單晶矽薄膜於另一基板上,製作絕緣層矽晶圓 材料 (SOI wafer)。
Description: Transfer a single crystal silicon layer with thickness less than 30 nm onto a handle substrate by the diffusion of implanted hydrogen at sufficient low dose.
(Figure: Adsorption dynamics of molecular hydrogen on silicon adopted from the website of Surface Physics Group in Marburg, Germany))
學術研究進度:2009年委託美國勞倫斯實驗室合成薄膜轉移預置埋層結構,並在加州矽谷一家公司完成氫離子植入步驟,初步驗證成功製作 8" 超級 品質 SOI 材料,相關專利申請中。
技術推展:擬建立試產線。
未來展望:不需研磨拋光,直接轉移製作 22 nm 厚度之大尺寸 SOI 晶圓材料。